椭偏仪在半导体薄膜厚度测量中的应用:基于光谱干涉椭偏法研究
薄膜厚度的测量在芯片制造和集成电路等领域中发挥着重要作用。椭偏法具备高测量精度的优点,利用宽谱测量方式可得到全光谱的椭偏参数,实现纳米级薄膜的厚度测量。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
为解决半导体领域常见的透明硅基底上薄膜厚度测量的问题并消除硅层的叠加信号,本文提出基于光谱干涉椭偏法的偏振分离式马赫曾德测量系统,以近红外飞秒激光器为光源,独立探测偏振信息,针对硅基底上二氧化硅薄膜开展测量,且该方法适用于透明或非透明基底薄膜测量,无需检测矫正步骤或光源更换,可应用于化学气相沉积、分子束外延等薄膜制备工艺成品的高精度检测。
1
椭偏仪基本原理
flexfilm

光谱干涉解算原理
椭偏法通过测量经过样品透射或反射的椭偏参数 (ψ,Δ) 并结合非线性最小二乘迭代过程,拟合得到薄膜的参数信息。
椭偏参数主要包括水平偏振分量p和垂直偏振分量s的振幅比和相位差,以反射型为例:
Rp:水平偏振分量的复振幅反射系数;Rs:垂直偏振分量的复振幅反射系数;i:虚数单位
不同偏振分量的复振幅反射系数可表示为:

r1,r2为与每一层的复折射率 N 和入射角 θ1有关的不同介质界面的振幅反射系数
正交的偏振分量的表示方法不同,可通过菲涅尔公式推导得到;β为薄膜的位相厚度,可表示为:
N 为薄膜层的复折射率;h为薄膜层的几何厚度;θ2为薄膜中的折射角;λ为光在真空中的波长。多层介质膜的椭偏参数可通过导纳矩阵和递推关系得到。
在其他条件固定时,椭偏参数是薄膜折射率、厚度和波长的函数,因相位差比强度比更具准确性与灵敏度,获取宽光谱椭偏参数后,利用多波长下的相位差可准确解耦薄膜厚度。光谱干涉椭偏法能获取水平偏振分量Ip和垂直偏振分量Is的光谱干涉强度信息。

将正交的偏振分量的相位作差即可得到椭偏参数,利用非线性最小二乘迭代椭偏公式,即可拟合得到薄膜的待测信息。
2
实验系统
flexfilm
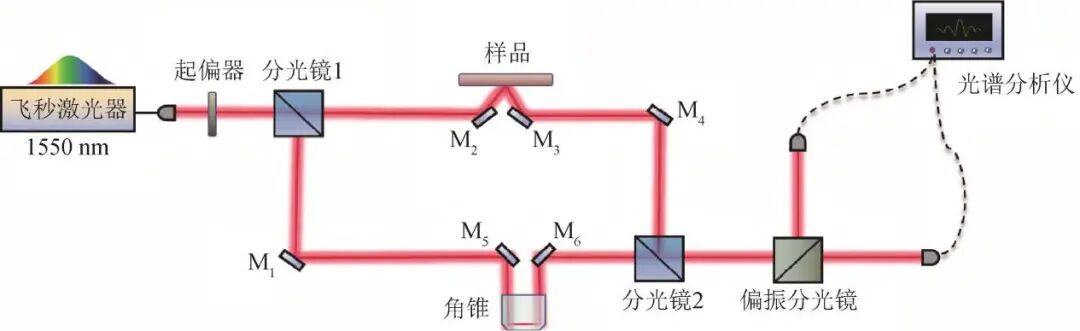
偏振分离式实验装置图
实验所用光源为实验室自制的非线性偏振旋转型光纤飞秒激光器,其中心波长为 1550 nm,输出功率约 8 mW,半高宽约 50 nm。种子光经准直器输出平行光进入空间系统,经过起偏器产生偏振方向为 45° 的线偏光,该线偏光被分光镜 1 分成两束进入马赫曾德系统,一束光倾斜照射到待测样品上,另一束光经过角锥产生等臂光束,这两束光在分光镜 2 处合光,最终由偏振分光镜分成正交偏振的两束光,分别被光谱分析仪探测。

系统标定初相位(a)干涉图(b)初相位

傅里叶变换域
由于各光学元件表面镀有介质膜,在测量过程中会引入系统误差,因此需要利用单面抛光的未镀膜纯硅片进行初相位标定,待测椭偏相位需减去该标定初相位。为进一步判断相位的准确性及系统的可复现性,通过移动角锥改变系统的初始光程,光程变化范围设定为 0.4 ~ 1.5 mm,观察移动过程中标定相位是否发生变化。从中可分析出依次上移 0.1rad 的偏置情况。为初步验证系统测量透明基底的可行性,利用该实验系统测量了双面抛光的纯硅片,通过傅里叶域滤波过程,能够消除后表面的误差信号,进而消除硅层的叠加信号。
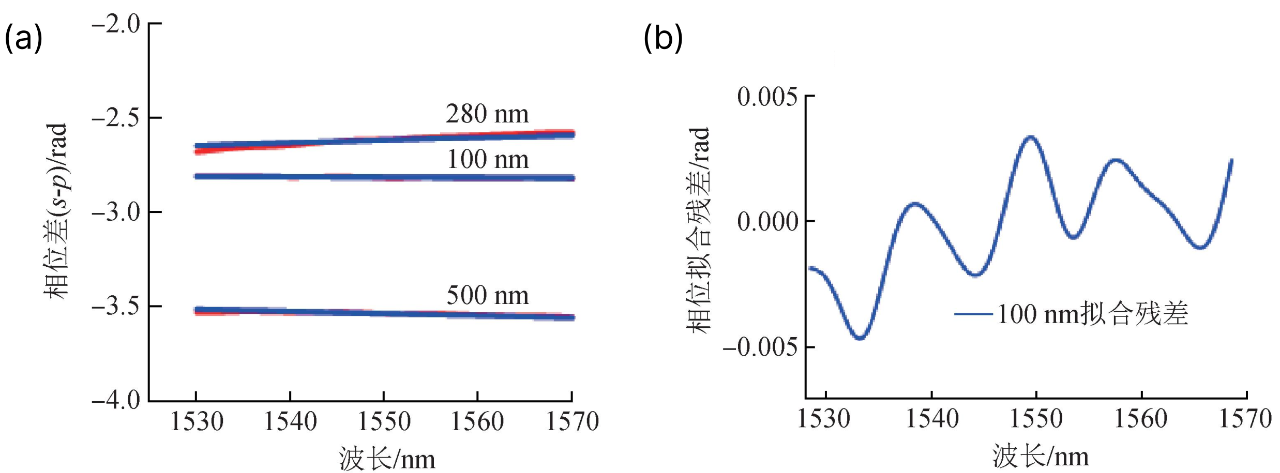
角度拟合结果
为标定入射角,实验采用三个标称膜厚值分别为100nm、280nm、500nm的沉积在单抛硅基底上的二氧化硅薄膜作为样品,并利用商用椭偏仪在1500 ~ 1600 nm光谱范围和 0.1nm 光谱分辨力下提前对这些样品的膜厚值进行测量,将测量结果作为已知值。以入射角作为迭代目标,以实测椭偏相位和理论椭偏相位为研究对象,找出残差最小处的入射角度,经过迭代计算和平均后,确定入射角为 48.4°。
3
实验结果
flexfilm
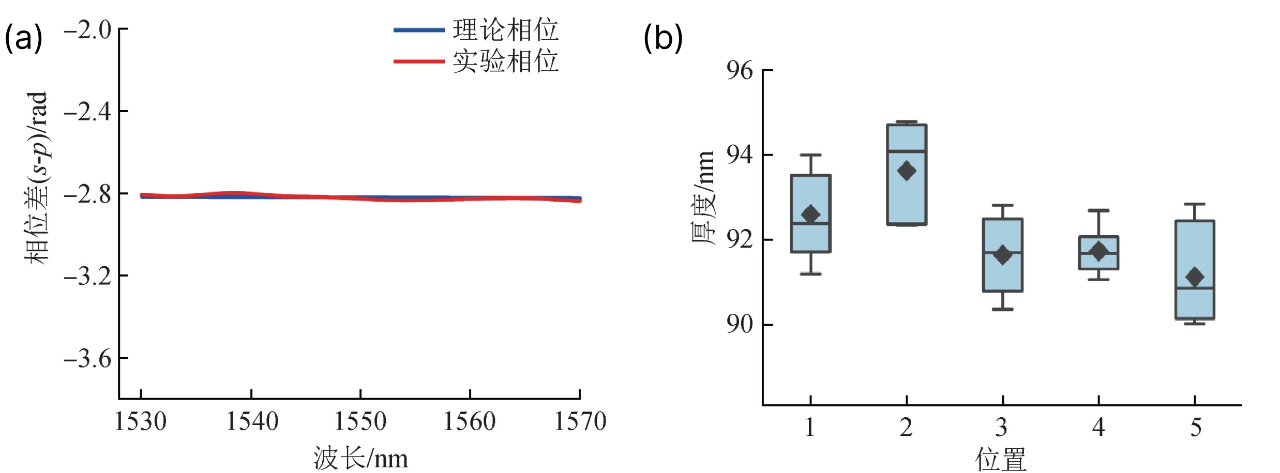
(a)实验和理论相位(b)测量结果
实验以透明双抛硅基底上镀二氧化硅薄膜作为样品,以 100nm 厚度的薄膜为例,测试该系统的薄膜厚度测量效果。

样品5个位置的测量结果
该系统对膜厚的测量精度可达到纳米级,对应相位差的稳定性可达10-3,这主要得益于光谱干涉法的高测量精度。为衡量测量结果的准确性,利用商用椭偏仪在待测中心区域选择相同的 5 个位置(由于无法保证商用椭偏仪和实验测量位置完全相同,因此采用 5 次测量结果的平均值来评估测量结果的准确性)进行测量,商用椭偏仪的厚度测量平均值为 92.04nm,实验的厚度测量平均值为 92.3nm,考虑到样品的均匀性误差和仪器的测量误差,该测量结果处于误差允许范围内。
本文提出了基于光谱干涉椭偏法的透明基底上薄膜厚度测量方法,建立了偏振分离式马赫曾德测量系统,并针对双抛硅基底上所镀二氧化硅薄膜厚度开展测量实验,以验证基于光谱干涉椭偏法的薄膜厚度测量方法的可行性与准确性。实验结果表明,该方法能够有效消除硅层的叠加信号,针对 100nm 厚度的二氧化硅薄膜,实现了纳米级的测量标准差。基于光谱干涉椭偏法的薄膜厚度测量方法具有准确性高、抗扰动性好的优点,可应用于对精度要求较高的光刻制造、显示设备研发、集成电路研制等领域。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《基于光谱干涉椭偏法的薄膜厚度测量》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
- 5类6类网线插座通用吗
- 瑞芯微(EASY EAI)RV1126B USB OTG模式
- 航裕电源HY-HV系列80kV可编程高压直流电源的应用案例
- LeadeRobot2026三大榜单正式揭晓,谁在定义具身智能的产业坐标?
- 实操手记:FSMR50 在射频计量与高精度测试中的应用体验
- 零知派——基于ESP32的BLE Mesh蓝牙组网系统(iOS/Android APP控制)
- 快速瞬态响应 + 三重保护!WD78C:传感器 / MCU 高可靠 LDO 芯片
- 合科泰肖特基二极管与MOSFET选型实战指南
- 瑞芯微(EASY EAI)RV1126B OTG切换成U盘模式
- CC LINK IE转CANOPEN,三菱PLC和温度变送器‘原地结婚’—网关这波‘绝绝子
- 机器人焊接生产线上欧姆龙CPM2AH PLC通过以太网模块和触摸屏、上位机进行通讯案例
- 瑞芯微(EASY EAI)RV1126B 自动校时与时区设置
- 块RAM存储器中的地址冲突场景
- 35kV直连型级联H桥固态变压器SST电压均衡新算法与多尺度协同控制
- 高精度贴片电阻品牌对比与选型攻略
- 多协议PLC通信管理平台的功能作用